ASMPT
TCB(Thermo-Compression Bonding) 매출 기여도가 컸다. 생성형 AI
시장 성장으로 이종접합에서 TCB 장비의 중요도가 높아지고 있다. Logic(Foundry, OSAT)
업체로부터 유의미한 TCB 장비 주문이 들어오고 있다. 특히 파운드리 고객사가 어드밴스
드 패키징 관련 CAPA를 확대하면서 TCB 수요가 증가하고 있다.
메모리 업체로부터 HBM
에 대한 Repeat Order(추가 수주)를 받았고, 다른 메모리 업체들과 협력을 지속하고 있
다.
ASMPT HB(Hybrid bonding)은 첫 수주를 확보한 뒤, 메모리를 포함한 다양
한 분야에서 핵심 고객들과의 퀄 테스트를 진행하고 있다.
현재 TCB 시장의 규모는 약 12억 달러에서 13억
달러로 추정되며, 하이브리드 본딩 시장은 향후 5년에서 6년 내에 10억 달러에서 20억
달러 정도로 예상한다.
TCB 시장 규모는 TCB가 필
요로 할 Interconnects(인터커넥터)의 수를 가정해야 하고, 생성형 AI 성장으로 TCB 시
장 성장이 가속화될 것으로 기대했다.

BESI
시장조사기관 YOLE에 따르면, 28년에는 HBM에서 하이브리드 본딩이 차지하는 비중이
36%가 될 것으로 예상했다. 분명한 건 HBM 내 모든 본딩 장비가 하이브리드 본딩으로
전환되는 것이 아니며, HB, TCB, AFM 기술이 함께 쓰일 것으로 예상했다.
BESI는 TCB 본더와 하이브리드 본딩 장비를 갖추고 있다. BESI의 TCB 본더는 비메모리
(Logic)쪽 중심으로 개발 중이며, 메모리 쪽도 개발 중이지만 비메모리쪽에 집중하고 있
다. 참고로 BESI는 1Q23말 미국 고객사로부터 TCB CW타입 첫 수주를 받은 바 있다. 하
이브리드 본딩이 범프 피치 5㎛ 이하 공정에서 사용되고, TCB는 20㎛ 이상에서 사용하
는 것이 일반적이다.

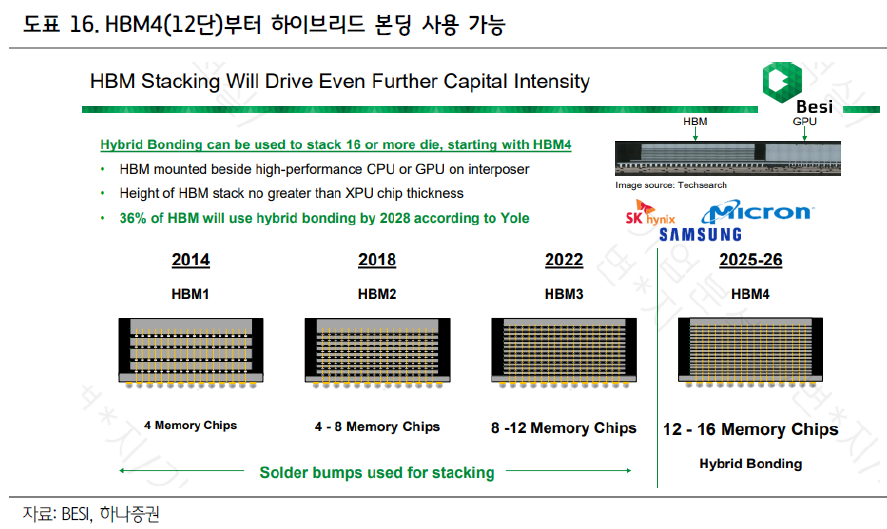
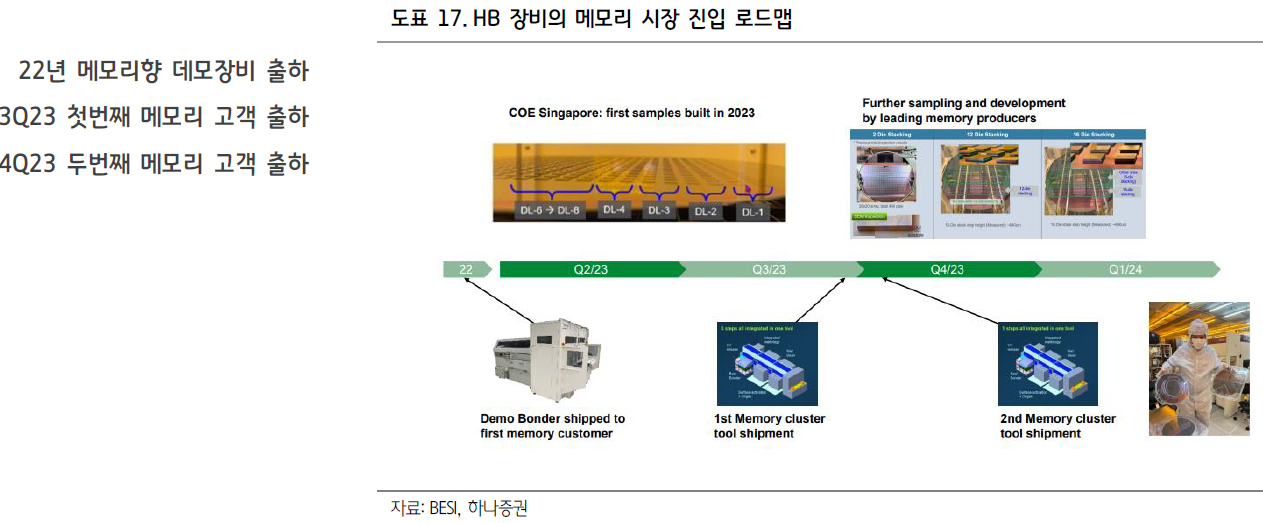
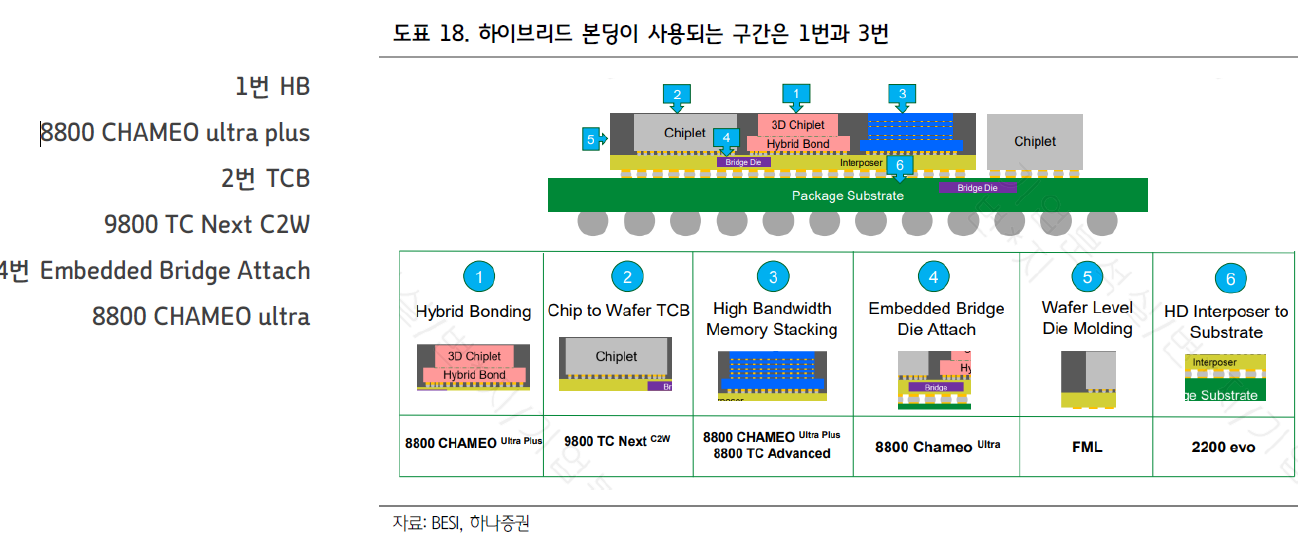

K&S
이종접합(heterogeneous integration)은 TCB와 HB 장비 등 여러 가지 패키지 기술로 구
성된다. HB와 TCB가 공존할 것으로 예상한다. K&S는 TC 본딩 C2S(chip to substrate)와
C2W(chip to wafer) 타입의 장비를 모두 공급하고 있다. 두 타입의 장비 모두 시장 규모
가 크고, TCB 시장 내 C2S와 C2W 시장 규모는 비슷할 것으로 전망했다. 현재 보편적인
범프 피치는 35㎛ 수준인데 HB는 10㎛ 이하 범프 피치에 집중하고 있다. TCB 시장이 HB
시장보다 크다는 의견에 동의했다.
K&S의 TCB 고객사로는 IDM, OSAT,
파운드리가 있다.